sip封裝工藝,sip封裝有哪幾種-KIA MOS管
信息來(lái)源:本站 日期:2025-06-27
系統(tǒng)級(jí)封裝SiP(Single In-line Package)是一種單列直插式集成電路封裝技術(shù),其引腳從封裝單側(cè)引出并呈直線排列,裝配至印刷電路板時(shí)呈側(cè)立狀態(tài)。該封裝標(biāo)準(zhǔn)引腳中心距為2.54mm,引腳數(shù)量范圍通常在2至23個(gè)之間,多為定制化產(chǎn)品。
sip封裝是將多個(gè)具有不同功能的有源電子元件與可選無(wú)源器件,以及諸如MEMS或者光學(xué)器件等其他器件優(yōu)先組裝到一起,實(shí)現(xiàn)一定功能的單個(gè)標(biāo)準(zhǔn)封裝件,形成一個(gè)系統(tǒng)或者子系統(tǒng)。
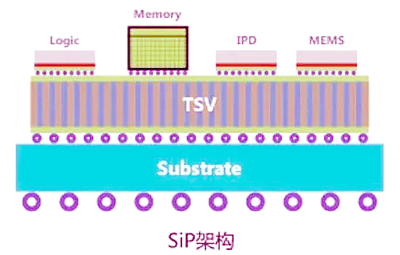
SiP封裝類(lèi)型
從目前業(yè)界SiP的設(shè)計(jì)類(lèi)型和結(jié)構(gòu)區(qū)分,SiP可分為三類(lèi):2D SiP、 堆疊SiP和3D SiP。
2D SiP封裝:是在同一個(gè)封裝基板上將芯片一個(gè)挨一個(gè)的排列以二維的模式封裝在一個(gè)封裝體內(nèi)。
堆疊SiP封裝:是在一個(gè)封裝中采用物理的方法將兩個(gè)或多個(gè)芯片堆疊整合起來(lái)進(jìn)行封裝。
3D SiP封裝:是在2D封裝的基礎(chǔ)上,把多個(gè)羅芯片、封裝芯片、多芯片甚至圓片進(jìn)行疊層互聯(lián),構(gòu)成立體封裝,這種結(jié)構(gòu)也稱(chēng)作疊層型3D封裝。
sip封裝核心工藝包括晶圓減薄、芯片貼裝、互連形成和封裝體構(gòu)建等步驟。
主要工藝步驟
1.晶圓準(zhǔn)備與減薄
原始晶圓厚度約700pm,需研磨至200pm以下,疊層存儲(chǔ)芯片需減薄至50pm。3·流程包括貼膜保護(hù)、背面研磨和清洗,防止芯片損傷。
2.芯片貼裝(Die Attach)
使用銀膠(環(huán)氧樹(shù)脂+銀粉)粘接芯片與基板,需控制溫度(120°℃)和壓力以確保牢固性。
關(guān)鍵設(shè)備包括固晶機(jī)、Pick up head等。
3.互連技術(shù)
引線鍵合(Wire Bonding):傳統(tǒng)金/銅線連接方式。
倒裝焊(Flip Chip):通過(guò)凸點(diǎn)直接連接芯片與基板,密度更高。
4.封裝體構(gòu)建。
包括錫膏印刷、回流焊、清洗及最終包封保護(hù)。
SiP封裝制程根據(jù)芯片與基板的連接方式,可分為引線鍵合封裝和倒裝焊兩種主要類(lèi)型。
引線鍵合封裝工藝流程:
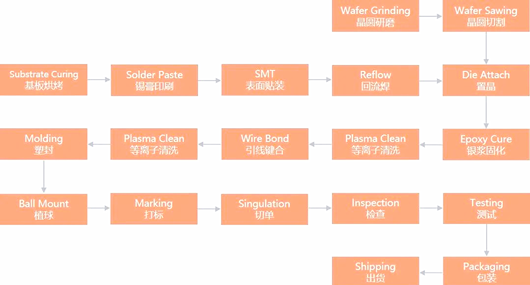
聯(lián)系方式:鄒先生
座機(jī):0755-83888366-8022
手機(jī):18123972950(微信同號(hào))
QQ:2880195519
聯(lián)系地址:深圳市龍華區(qū)英泰科匯廣場(chǎng)2棟1902
搜索微信公眾號(hào):“KIA半導(dǎo)體”或掃碼關(guān)注官方微信公眾號(hào)
關(guān)注官方微信公眾號(hào):提供 MOS管 技術(shù)支持
免責(zé)聲明:網(wǎng)站部分圖文來(lái)源其它出處,如有侵權(quán)請(qǐng)聯(lián)系刪除。
